
SIMS con AFM per misure 3D
Lo strumento per la caratterizzazione nano
Le informazioni relative alla composizione chimica, alle proprietà fisiche e alla struttura tridimensionale dei materiali e dispositivi su scala nanometrica, sono di grande importanza per i nuovi sviluppi nelle nanoscienze e nelle nanotecnologie. In una misura SIMS 3D la topografia iniziale della superficie del campione e le modifiche topografiche durante l’esperimento non possono essere facilmente identificate, la microscopia a scansione a scansione (SPM) fornisce informazioni complementari sulla topografia della superficie e può anche essere utilizzata per misurare le proprietà fisiche dell’analisi campione.
Attraverso la combinazione di queste due tecniche diventa possibile immagini chimiche tridimensionali in situ. La nuova piattaforma M6 Plus combina le prestazioni di fascia alta dell’M6 con la possibilità di eseguire misurazioni SPM in situ. L’unità SPM ha un’ampia area di scansione ed è ideale per fornire informazioni topografiche per misurazioni SIMS 3D reali.
- Potente strumento per la nano caratterizzazione
- Tutte le modalità SPM standard, ad es. AFM, MFM, KPFM, multi-frequenza
- Ampio intervallo di scansione SPM di 80 x 80 x 10 µm3
- Modalità di profilometria superficiale unica, per misurazioni di crateri SIMS di grandi dimensioni
- Piena compatibilità con tutte le opzioni M6
Accuratezza della posizione del micrometro 
Lo stage portacampioni dell’M6 Plus, ha una precisione di posizionamento inferiore al micron e assicura un movimento rapido e preciso tra la TOF-SIMS e la posizione di misurazione SPM.
Lo stage ha una risoluzione dell’encoder di 10 nm e velocità di traslazione fino a 10 mm / s che garantiscono un alto livello di precisione e stabilità.
Imaging chimico 3D Reale
L’esempio seguente mostra un’analisi tridimensionale di una struttura di germanio all’interno di una matrice di silicio. La struttura ha una forte topografia superficiale iniziale che porta a una rappresentazione errata della composizione chimica se si utilizzassero i soli dati TOF-SIMS. Combinando le informazioni chimiche del TOF-SIMS con le informazioni dimensionali dell’ SPM si può generare una vera immagine chimica tridimensionale.
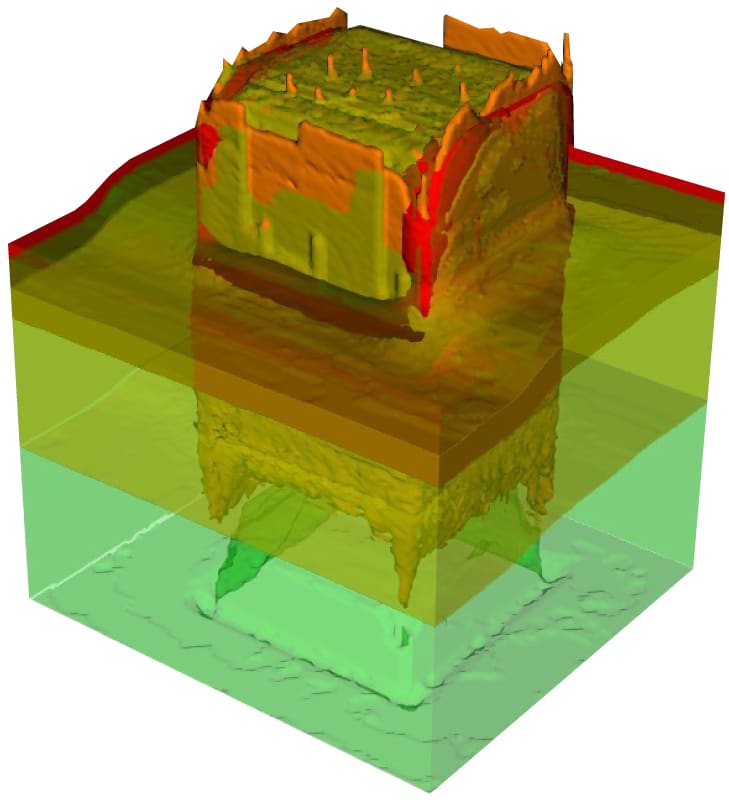
Sovrapposizione 3D con correzione della topografia
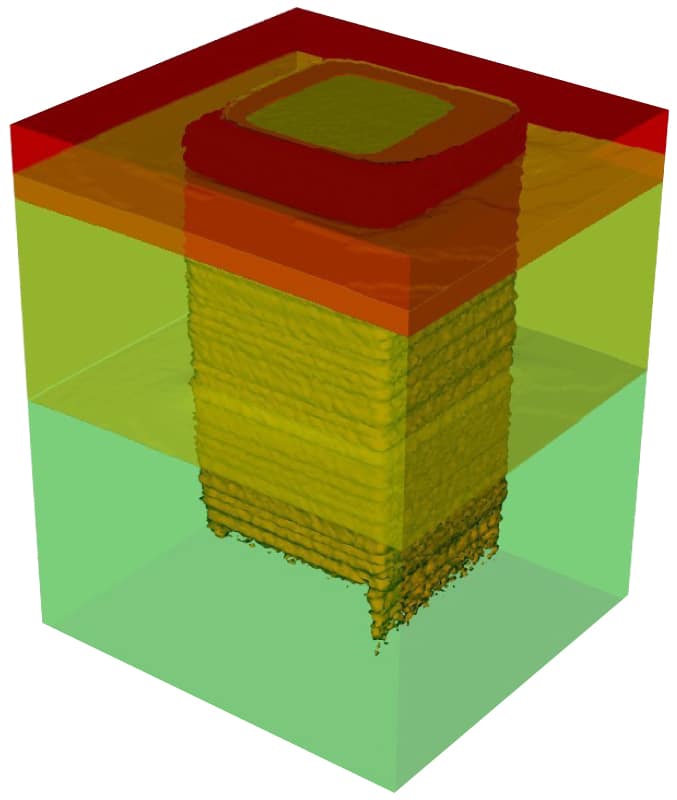
Sovrapposizione 3D senza correzione della topografia
Modalità profilometro
Il modulo SPM dell’M6 Plus consente anche l’analisi dettagliata di grandi crateri di sputtering. Nella cosiddetta modalità profilometria di superficie più scansioni SPM sono unite per misurare lunghe scansioni di linee SPM. Questa esclusiva modalità SPM è estremamente preziosa per determinare con precisione la profondità dei crateri sputter o per misurare la rugosità del cratere su scala nanometrica.

L’esempio mostra una scansione in modalità profilometro di superficie SPM di un cratere di SIMS profondo 1,1 µm in silicio. La scansione di linea è composta da più scansioni SPM individuali. Il tempo di registrazione per l’intera scansione è stato inferiore a 3 minuti e ha rivelato una rugosità superficiale di 0,7 nm (RMS) all’esterno e 10,3 nm (RMS) all’interno del cratere.



